





















病例摘要
FE1.1S HUB芯片
裝機(jī)服役約3-6個(gè)月
突發(fā)性功能喪失,導(dǎo)致所在設(shè)備USB端口無法識別任何外接設(shè)備
同一批次多個(gè)“個(gè)體”先后出現(xiàn)類似癥狀,更換新芯片后設(shè)備暫時(shí)恢復(fù)正常
病因不明,復(fù)發(fā)風(fēng)險(xiǎn)高,需進(jìn)行系統(tǒng)性「尸體解剖」與「病理分析」以查明根本死因
我們常面臨一個(gè)典型困境:芯片外觀完好,卻功能盡失。這背后究竟是芯片自身存在設(shè)計(jì)或工藝的先天缺陷,還是在生產(chǎn)、運(yùn)輸或使用中受到了外部應(yīng)力的不可逆損傷?
為此,我們對其展開了一次系統(tǒng)的 “工業(yè)診斷”...
外觀檢查
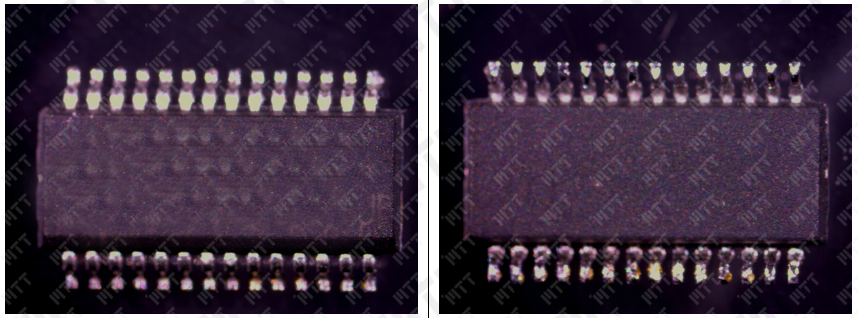
NG樣品外觀圖
芯片體表完好,無破損、燒蝕、變形等外傷跡象。
?? 初步排除機(jī)械損傷與外部過熱致死可能。
I-V曲線測試

NG4樣品I-V曲線典型圖

NG5樣品I-V曲線典型圖
對比健康芯片后發(fā)現(xiàn),部分失效芯片的 “11號引腳”對地電阻異常,呈現(xiàn)阻性甚至短路狀態(tài)。
?? 這說明內(nèi)部特定電路節(jié)點(diǎn)已受損,如同某條關(guān)鍵血管發(fā)生了“梗塞”。
無損透視 & 超聲掃描
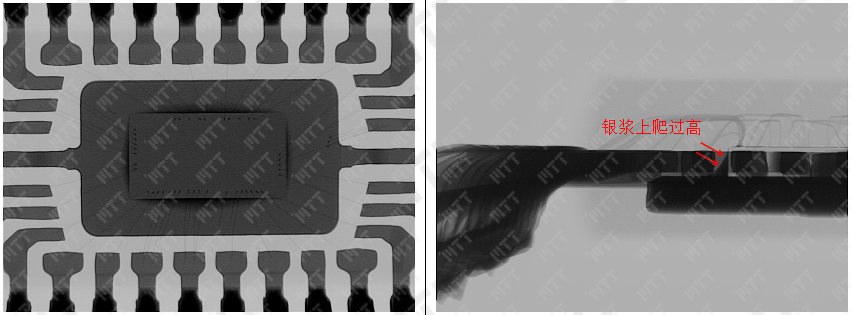
NG2樣品X-ray檢測圖
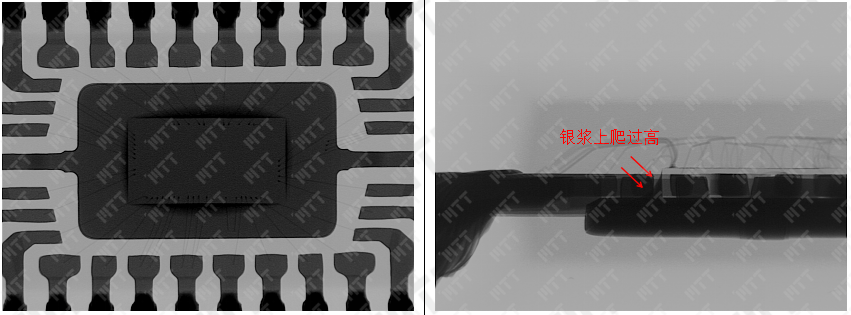
NG4樣品X-ray檢測圖
X光(內(nèi)部結(jié)構(gòu)):發(fā)現(xiàn)部分芯片存在 “銀漿上爬過高” 的工藝瑕疵。這好比局部“組織增生”,在潮濕環(huán)境下易引發(fā)“遷移感染”(電遷移短路),屬于長期風(fēng)險(xiǎn)。

超聲掃描圖-二焊點(diǎn)

超聲掃描圖-基板
超聲(內(nèi)部結(jié)合):檢出個(gè)別樣本存在內(nèi)部 “分層” (結(jié)合不良)。這類似于“組織粘連不牢”,影響長期健康,但并非本次急性死亡的直接原因。
?? 發(fā)現(xiàn)了一些“慢性病”跡象,但還不是導(dǎo)致本次“猝死”的致命一刀。
開封內(nèi)部觀察
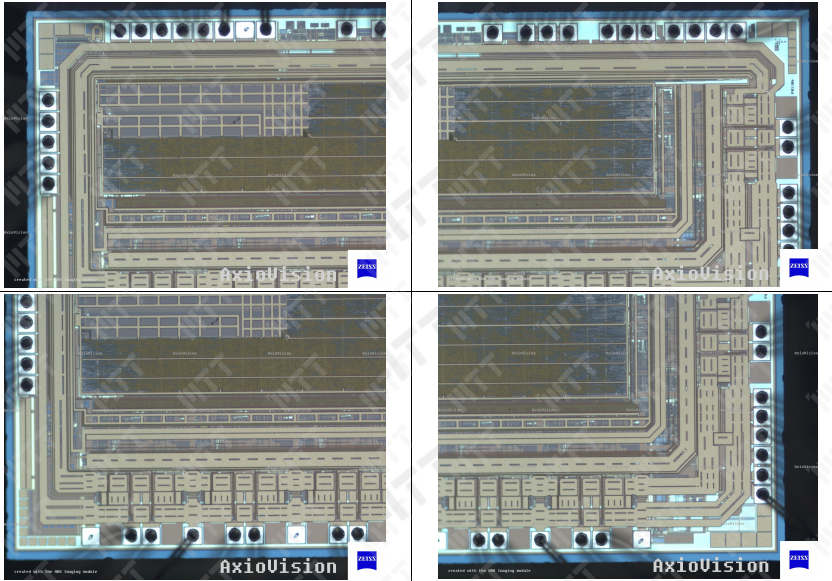
NG樣品開封圖
去除外殼后,直接觀察芯片晶圓表面,仍未發(fā)現(xiàn)明顯壞死(燒毀)點(diǎn),且異常電性能依舊存在。
?? 這基本排除了“銀漿遷移”導(dǎo)致急性短路的可能,病因繼續(xù)向更深處隱藏。
Thermal EMMI熱點(diǎn)定位 & 剝離分析
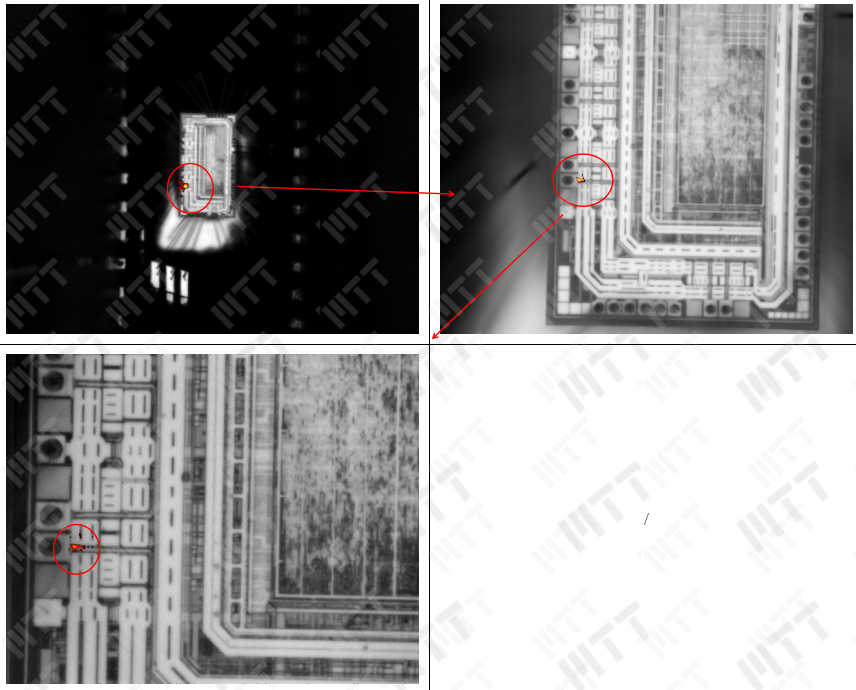
NG4樣品定位分析圖
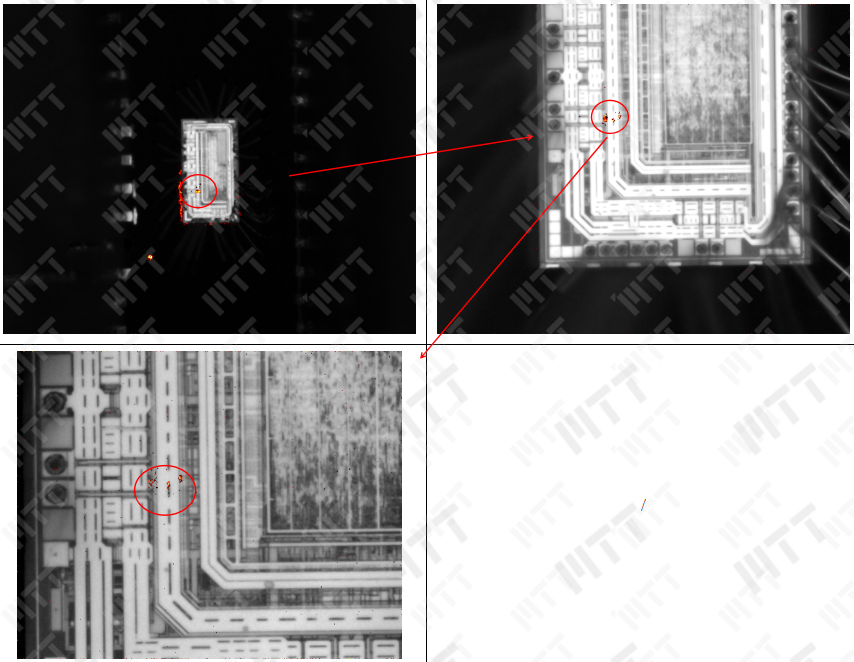
NG5樣品定位分析圖
這是關(guān)鍵一步。我們利用Thermal EMMI技術(shù),像使用紅外熱成像儀一樣,定位芯片在工作時(shí)的異常發(fā)熱點(diǎn)。在異常的11號引腳附近,靜電保護(hù)電路區(qū)域出現(xiàn)了異常“高熱”信號。
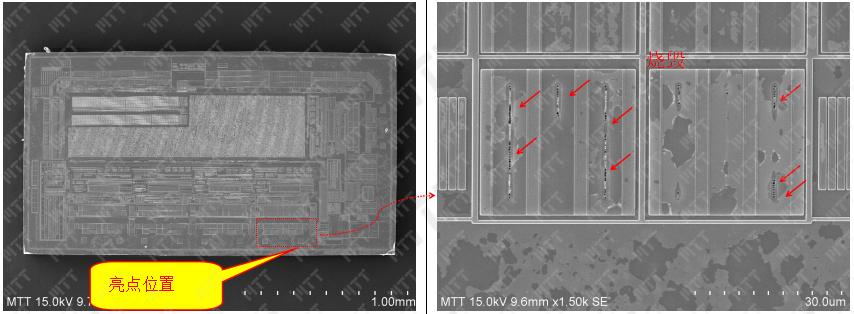
NG4樣品亮點(diǎn)位置形貌圖
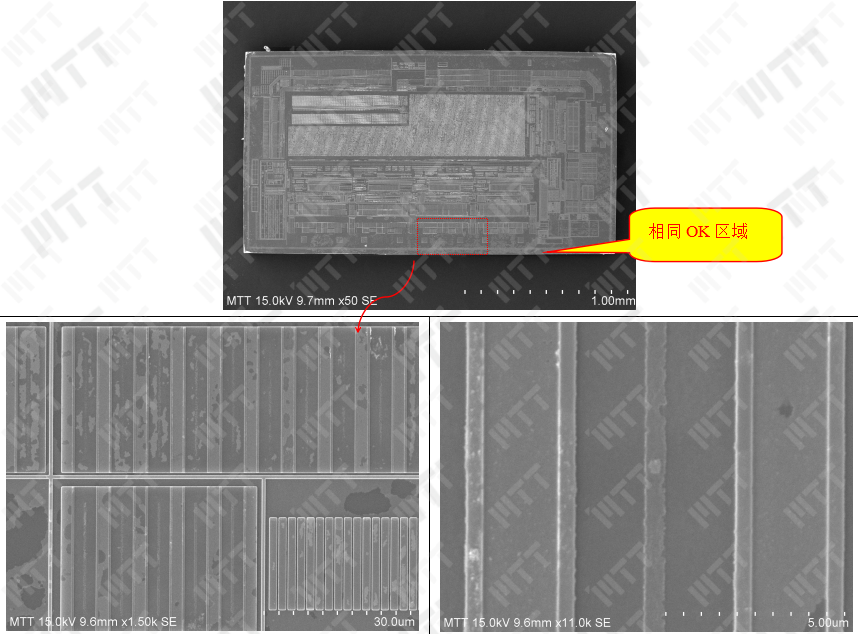
NG4樣品相同OK區(qū)域形貌圖
通過化學(xué)方法逐層剝離(類似病理切片),在該區(qū)域觀察到了微米級的燒毀形貌。
?? 至此,兇器露出端倪:損傷集中在芯片的“免疫系統(tǒng)”——靜電保護(hù)電路上。
驗(yàn)證實(shí)驗(yàn):重現(xiàn)“現(xiàn)場”

OK樣品人體靜電實(shí)驗(yàn)圖
推測是靜電擊穿,但需要證實(shí)。我們對健康芯片進(jìn)行了 “靜電攻擊模擬實(shí)驗(yàn)” 。對同型號健康芯片的相同引腳,施加標(biāo)準(zhǔn)的人體模型(HBM)靜電脈沖。
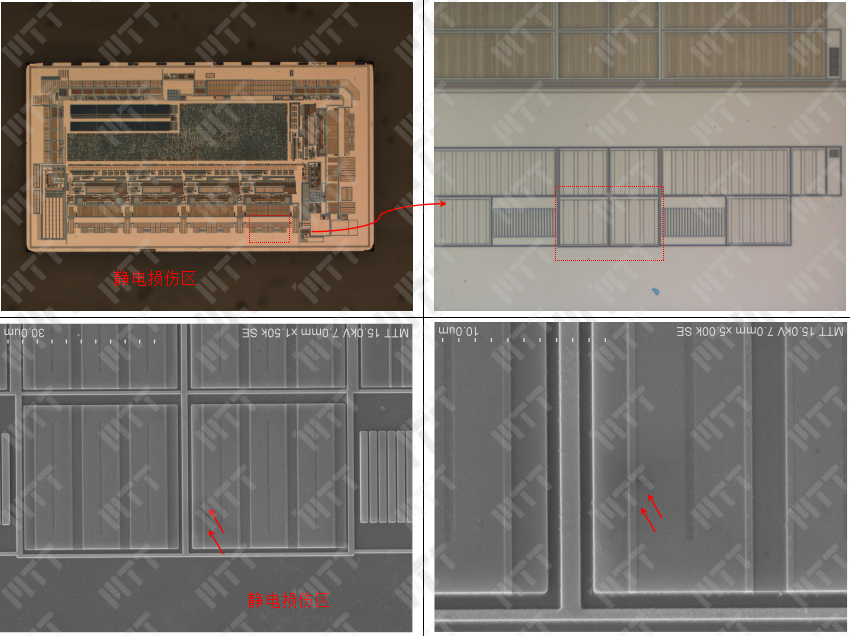
靜電模擬實(shí)驗(yàn)后芯片剝離后SEM圖
當(dāng)靜電電壓達(dá)到4-4.4 kV時(shí),芯片在完全相同的保護(hù)電路位置被擊穿,且擊穿損傷的微觀形貌與失效芯片的燒毀特征高度一致。
?? 該失效芯片曾暴露在靜電放電環(huán)境中,保護(hù)電路受到隱性損傷。隨后在多次正常上電工作中,損傷點(diǎn)不斷惡化,最終導(dǎo)致保護(hù)電路燒毀,功能徹底喪失。
?? 最終診斷
直接原因:芯片內(nèi)部出現(xiàn)燒毀。
根本原因:芯片承受了較大的靜電損傷,在后續(xù)的上電過程中,擊穿位置出現(xiàn)燒毀,最終導(dǎo)致芯片失效。
??? 治療建議
加強(qiáng)芯片在運(yùn)輸及使用過程中的靜電防護(hù)。
芯片本身存在可靠性應(yīng)用風(fēng)險(xiǎn),與物料供應(yīng)商溝通改良。
在你們的工作中,是否有過因靜電導(dǎo)致的“懸案”?后來是如何破案并建立防線的?或者,你對ESD防護(hù)有哪些獨(dú)到的經(jīng)驗(yàn)和困惑?





